
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in der Chipherstellung: Ein professioneller Nachrichtenbericht
Die Entwicklung von Halbleitermaterialien
Im Bereich der modernen Halbleitertechnologie hat der unaufhörliche Drang zur Miniaturisierung die Grenzen traditioneller Materialien auf Siliziumbasis erweitert. Um den Anforderungen an hohe Leistung und geringen Stromverbrauch gerecht zu werden, hat sich SiGe (Siliziumgermanium) aufgrund seiner einzigartigen physikalischen und elektrischen Eigenschaften als Verbundmaterial der Wahl bei der Herstellung von Halbleiterchips herausgestellt. Dieser Artikel befasst sich mit derEpitaxieverfahrenvon SiGe und seine Rolle beim epitaktischen Wachstum, bei Anwendungen mit verspanntem Silizium und bei Gate-All-Around (GAA)-Strukturen.
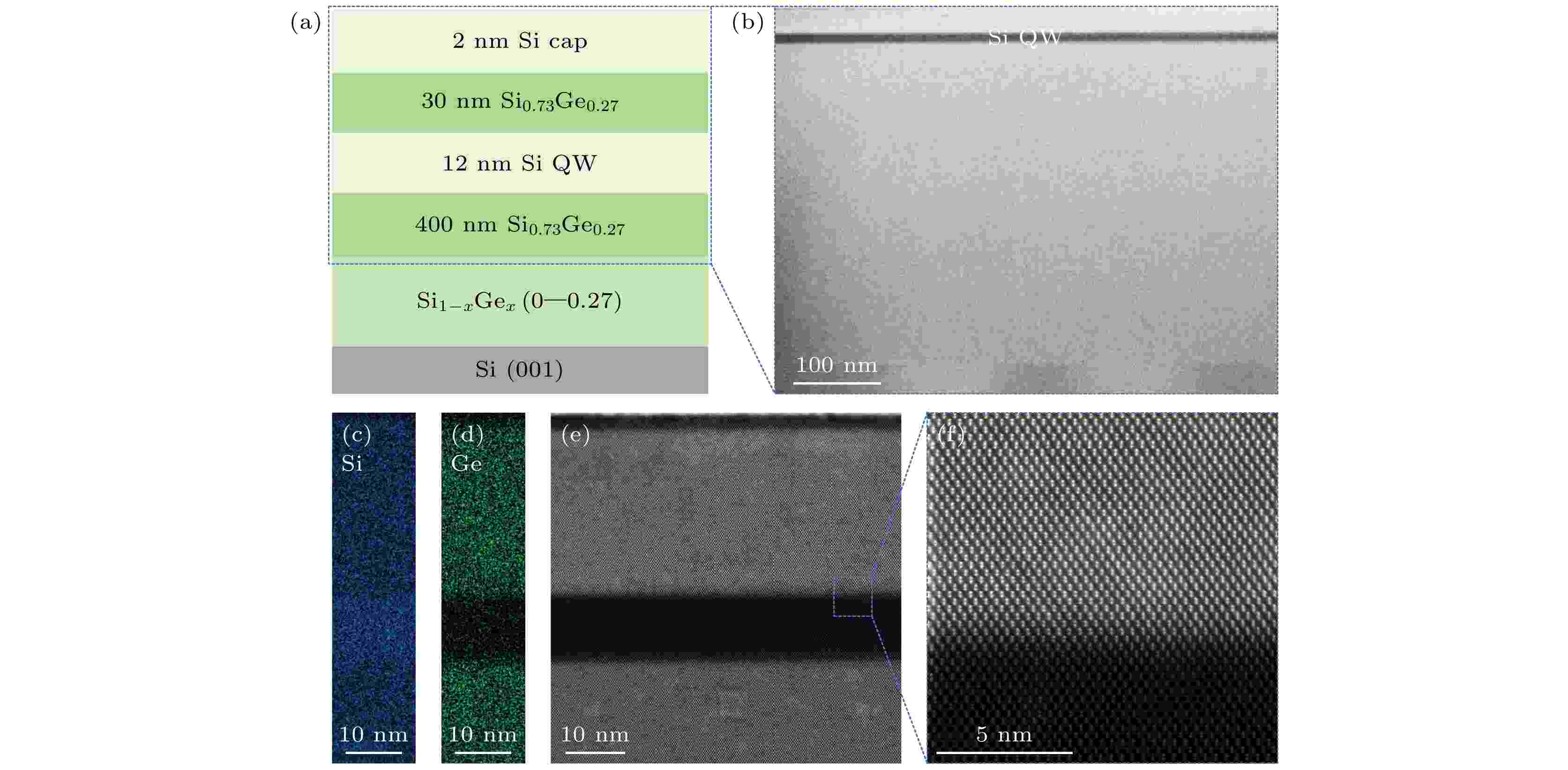
Die Bedeutung der SiGe-Epitaxie
1.1 Einführung in die Epitaxie in der Chipherstellung:
Epitaxie, oft als Epi abgekürzt, bezeichnet das Wachstum einer einkristallinen Schicht auf einem einkristallinen Substrat mit derselben Gitteranordnung. Diese Schicht kann entweder seinHomoepitaktisch (z. B. Si/Si)oder heteroepitaxial (wie SiGe/Si oder SiC/Si). Für das epitaktische Wachstum werden verschiedene Methoden eingesetzt, darunter Molekularstrahlepitaxie (MBE), chemische Gasphasenabscheidung im Ultrahochvakuum (UHV/CVD), Atmosphären- und Unterdruckepitaxie (ATM & RP Epi). Dieser Artikel konzentriert sich auf die Epitaxieprozesse von Silizium (Si) und Silizium-Germanium (SiGe), die häufig bei der Herstellung integrierter Halbleiterschaltungen mit Silizium als Substratmaterial eingesetzt werden.
1.2 Vorteile der SiGe-Epitaxie:
Einarbeitung eines gewissen Anteils an Germanium (Ge).Epitaxieverfahrenbildet eine SiGe-Einkristallschicht, die nicht nur die Bandlückenbreite verringert, sondern auch die Grenzfrequenz (fT) des Transistors erhöht. Dadurch ist es in Hochfrequenzgeräten für die drahtlose und optische Kommunikation umfassend einsetzbar. Darüber hinaus führt die Gitterfehlanpassung (etwa 4 %) zwischen Ge und Si in fortgeschrittenen integrierten CMOS-Schaltkreisprozessen zu Gitterspannungen, die die Beweglichkeit von Elektronen oder Löchern erhöhen und somit den Sättigungsstrom und die Reaktionsgeschwindigkeit des Geräts erhöhen.
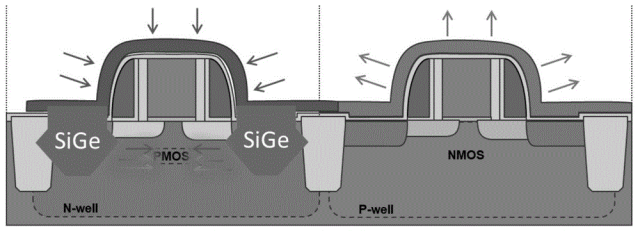
Der umfassende SiGe-Epitaxie-Prozessablauf
2.1 Vorbehandlung:
Siliziumwafer werden entsprechend den gewünschten Prozessergebnissen vorbehandelt. Dabei geht es in erster Linie um die Entfernung der natürlichen Oxidschicht und Verunreinigungen auf der Waferoberfläche. Bei stark dotierten Substratwafern ist es wichtig zu prüfen, ob eine Rückversiegelung erforderlich ist, um die Autodotierung während der Folge zu reduzierenEpitaxiewachstum.
2.2 Wachstumsgase und -bedingungen:
Siliziumgase: Silan (SiH₄), Dichlorsilan (DCS, SiH₂Cl₂) und Trichlorsilan (TCS, SiHCl₃) sind die drei am häufigsten verwendeten Siliziumgasquellen. SiH₄ eignet sich für vollständige Epitaxieprozesse bei niedrigen Temperaturen, während TCS, das für seine schnelle Wachstumsrate bekannt ist, häufig für die Herstellung dicker Schichten verwendet wirdSiliziumepitaxieSchichten.
Germaniumgas: Germane (GeH₄) ist die Hauptquelle für die Zugabe von Germanium und wird in Verbindung mit Siliziumquellen zur Bildung von SiGe-Legierungen verwendet.
Selektive Epitaxie: Selektives Wachstum wird durch Anpassen der relativen Geschwindigkeiten erreichtepitaktische Abscheidungund In-situ-Ätzen unter Verwendung von chlorhaltigem Siliziumgas DCS. Die Selektivität ist darauf zurückzuführen, dass die Adsorption von Cl-Atomen auf der Siliziumoberfläche geringer ist als auf Oxiden oder Nitriden, was das epitaktische Wachstum erleichtert. SiH₄, das keine Cl-Atome aufweist und eine niedrige Aktivierungsenergie aufweist, wird im Allgemeinen nur für vollständige Epitaxieprozesse bei niedrigen Temperaturen eingesetzt. Eine andere häufig verwendete Siliziumquelle, TCS, hat einen niedrigen Dampfdruck und ist bei Raumtemperatur flüssig, so dass H₂-Einleitung in die Reaktionskammer erforderlich ist. Es ist jedoch relativ kostengünstig und wird aufgrund seiner schnellen Wachstumsrate (bis zu 5 μm/min) häufig zum Züchten dickerer Silizium-Epitaxieschichten verwendet, was häufig bei der Herstellung von Silizium-Epitaxie-Wafern eingesetzt wird.
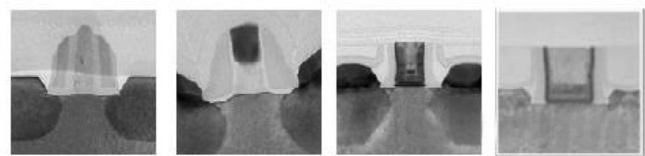
Verspanntes Silizium in Epitaxieschichten
Währendepitaktisches Wachstum, epitaktisches einkristallines Si wird auf einer entspannten SiGe-Schicht abgeschieden. Aufgrund der Gitterfehlanpassung zwischen Si und SiGe ist die Si-Einkristallschicht einer Zugspannung durch die darunter liegende SiGe-Schicht ausgesetzt, was die Elektronenmobilität in NMOS-Transistoren erheblich erhöht. Diese Technologie erhöht nicht nur den Sättigungsstrom (Idsat), sondern verbessert auch die Reaktionsgeschwindigkeit des Geräts. Bei PMOS-Bauelementen werden SiGe-Schichten nach dem Ätzen epitaktisch in den Source- und Drain-Bereichen aufgewachsen, um eine Druckspannung auf den Kanal einzuführen, die Lochbeweglichkeit zu verbessern und den Sättigungsstrom zu erhöhen.
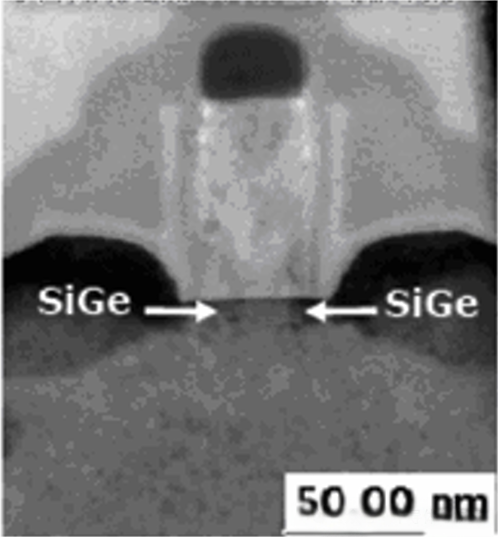
SiGe als Opferschicht in GAA-Strukturen
Bei der Herstellung von Gate-All-Around (GAA)-Nanodrahttransistoren fungieren SiGe-Schichten als Opferschichten. Hochselektive anisotrope Ätztechniken, wie etwa das Ätzen von quasi-atomaren Schichten (Quasi-ALE), ermöglichen die präzise Entfernung von SiGe-Schichten zur Bildung von Nanodraht- oder Nanoblattstrukturen.
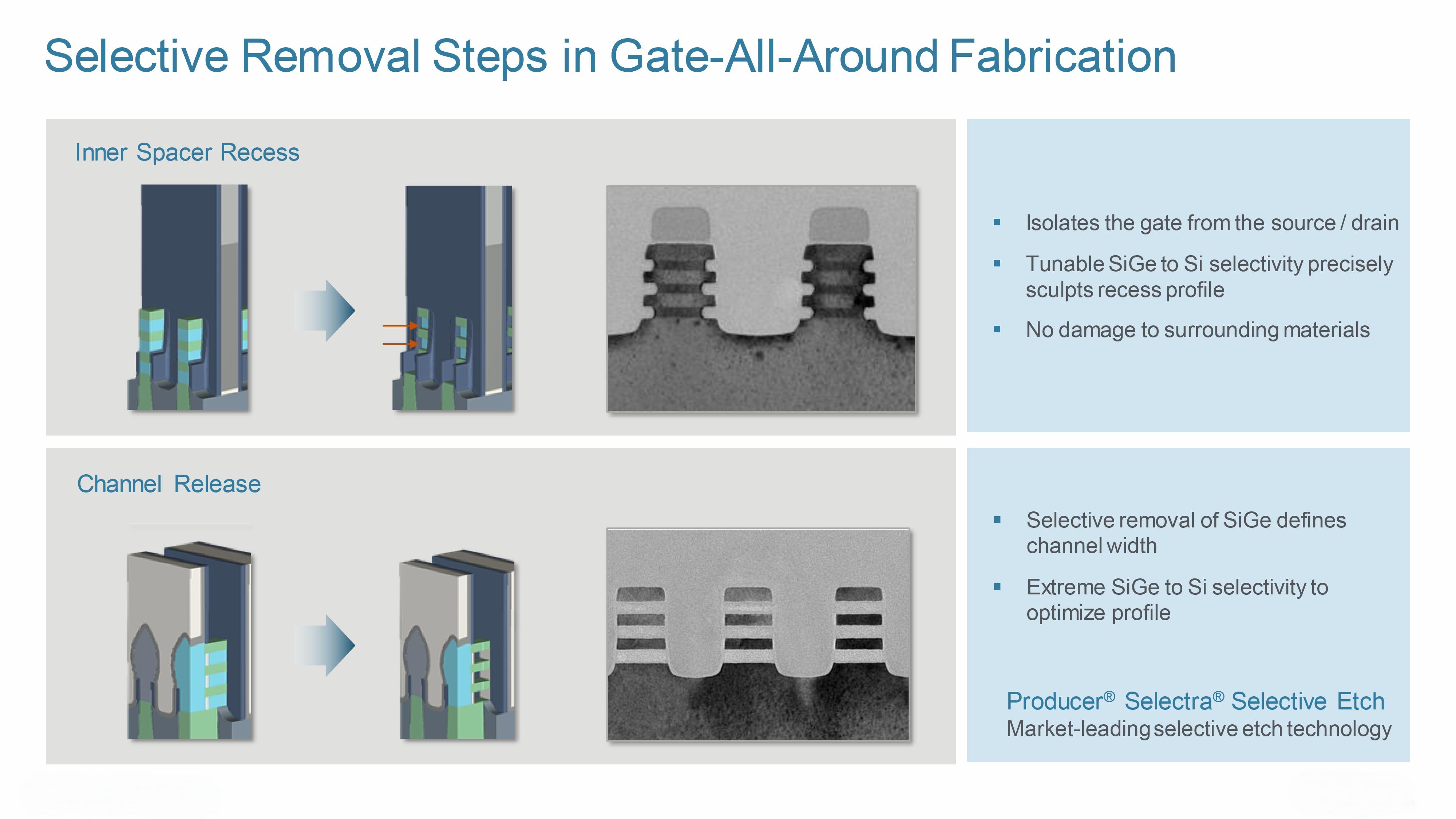
Wir bei Semicorex sind spezialisiert aufSiC/TaC-beschichtete GraphitlösungenAnwendung beim Si-Epitaxiewachstum in der Halbleiterfertigung. Wenn Sie Fragen haben oder weitere Informationen benötigen, zögern Sie bitte nicht, mit uns Kontakt aufzunehmen.
Kontakttelefon: +86-13567891907
E-Mail: sales@semicorex.com




