
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Prozess des Substratschneidens und -schleifens
Das SiC-Substratmaterial ist der Kern des SiC-Chips. Der Herstellungsprozess des Substrats erfolgt wie folgt: Nach Erhalt des SiC-Kristallbarrens durch Einkristallwachstum; dann die VorbereitungSiC-Substraterfordert Glätten, Abrunden, Schneiden, Schleifen (Ausdünnen); mechanisches Polieren, chemisch-mechanisches Polieren; und Reinigung, Prüfung usw. Prozess
Es gibt drei Hauptmethoden des Kristallwachstums: physikalischer Dampftransport (PVT), chemische Gasphasenabscheidung bei hoher Temperatur (HT-CVD) und Flüssigphasenepitaxie (LPE). Die PVT-Methode ist derzeit die gängige Methode für das kommerzielle Wachstum von SiC-Substraten. Die Wachstumstemperatur von SiC-Kristallen liegt über 2000 °C, was eine hohe Temperatur- und Druckkontrolle erfordert. Derzeit gibt es Probleme wie eine hohe Versetzungsdichte und viele Kristalldefekte.
Beim Substratschneiden wird der Kristallbarren für die anschließende Verarbeitung in Wafer geschnitten. Die Schneidmethode beeinflusst die Koordination des anschließenden Schleifens und anderer Prozesse von Siliziumkarbid-Substratwafern. Das Schneiden von Barren basiert hauptsächlich auf dem Mörtel-Mehrdrahtschneiden und dem Schneiden mit Diamantdrahtsägen. Die meisten vorhandenen SiC-Wafer werden mit Diamantdraht geschnitten. Allerdings weist SiC eine hohe Härte und Sprödigkeit auf, was zu einer geringen Waferausbeute und hohen Verbrauchskosten für Schneiddrähte führt. Erweiterte Fragen. Gleichzeitig ist die Schnittzeit bei 8-Zoll-Wafern deutlich länger als bei 6-Zoll-Wafern und auch die Gefahr, dass die Schnittlinien stecken bleiben, ist höher, was zu einer geringeren Ausbeute führt.
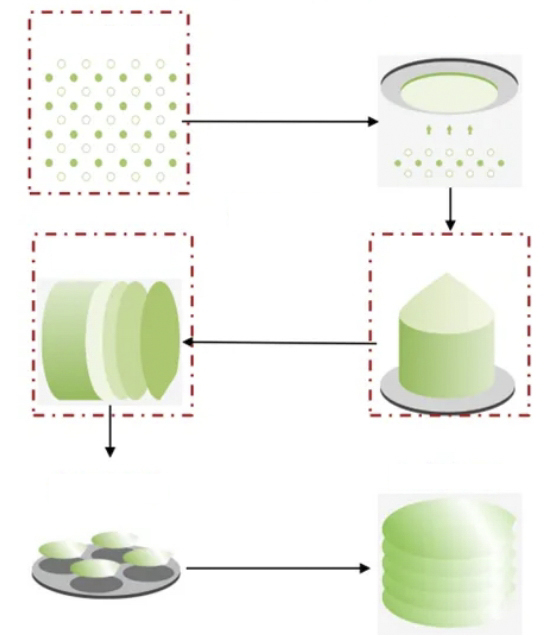
Der Entwicklungstrend der Substratschneidetechnologie ist das Laserschneiden, das eine modifizierte Schicht im Inneren des Kristalls bildet und den Wafer vom Siliziumkarbidkristall ablöst. Es handelt sich um eine berührungslose Verarbeitung ohne Materialverlust und ohne Beschädigung durch mechanische Belastung, sodass der Verlust geringer, die Ausbeute höher und die Verarbeitungsmethode flexibler ist und die Oberflächenform des verarbeiteten SiC besser ist.
SiC-SubstratDie Schleifbearbeitung umfasst Schleifen (Verdünnen) und Polieren. Der Planarisierungsprozess von SiC-Substraten umfasst hauptsächlich zwei Prozessrouten: Schleifen und Verdünnen.
Das Schleifen wird in Grobschleifen und Feinschleifen unterteilt. Die gängige Lösung für den Grobschleifprozess ist eine Gusseisenscheibe in Kombination mit einer Einkristall-Diamant-Schleifflüssigkeit. Nach der Entwicklung von polykristallinem Diamantpulver und polykristallinähnlichem Diamantpulver ist die Siliziumkarbid-Feinschleifprozesslösung ein Polyurethan-Pad, kombiniert mit einer polykristallinähnlichen Feinschleifflüssigkeit. Die neue Prozesslösung besteht aus einem wabenförmigen Polierpad in Kombination mit agglomerierten Schleifmitteln.
Das Verdünnen ist in zwei Schritte unterteilt: Grobschleifen und Feinschleifen. Die Lösung aus Effiliermaschine und Schleifscheibe wird übernommen. Es verfügt über einen hohen Automatisierungsgrad und soll den schleiftechnischen Weg ersetzen. Die Lösung des Ausdünnungsprozesses ist rationalisiert, und durch das Ausdünnen hochpräziser Schleifscheiben kann einseitiges mechanisches Polieren (DMP) für den Polierring eingespart werden. Die Verwendung von Schleifscheiben ermöglicht eine schnelle Bearbeitungsgeschwindigkeit, eine starke Kontrolle über die Form der Bearbeitungsoberfläche und eignet sich für die Bearbeitung großer Wafer. Gleichzeitig handelt es sich beim Dünnen im Vergleich zur doppelseitigen Schleifbearbeitung um einen einseitigen Bearbeitungsprozess, der ein Schlüsselprozess für das Schleifen der Rückseite des Wafers während der epitaktischen Herstellung und Waferverpackung darstellt. Die Schwierigkeit bei der Förderung des Ausdünnungsprozesses liegt in der schwierigen Forschung und Entwicklung von Schleifscheiben und den hohen Anforderungen an die Fertigungstechnologie. Der Lokalisierungsgrad von Schleifscheiben ist sehr gering und die Kosten für Verbrauchsmaterialien hoch. Derzeit wird der Schleifscheibenmarkt hauptsächlich von DISCO besetzt.
Polieren wird zum Glätten verwendetSiC-Substrat, beseitigen Sie Oberflächenkratzer, reduzieren Sie die Rauheit und beseitigen Sie Verarbeitungsstress. Es ist in zwei Schritte unterteilt: Grobpolieren und Feinpolieren. Aluminiumoxid-Polierflüssigkeit wird häufig zum Grobpolieren von Siliziumkarbid verwendet, und Aluminiumoxid-Polierflüssigkeit wird hauptsächlich zum Feinpolieren verwendet. Polierflüssigkeit aus Siliziumoxid.




