
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Was sind die LPCVD-Prozesse?
Bei der chemischen Gasphasenabscheidung bei niedrigem Druck (LPCVD) handelt es sich um CVD-Techniken, bei denen dünne Filmmaterialien in Niederdruckumgebungen auf Waferoberflächen abgeschieden werden. LPCVD-Prozesse werden häufig in Materialabscheidungstechnologien für die Halbleiterfertigung, Optoelektronik und Dünnschichtsolarzellen eingesetzt.
Die Reaktionsprozesse von LPCVD werden typischerweise in einer Niederdruck-Reaktionskammer durchgeführt, normalerweise bei einem Druck von 1–10 Torr. Nachdem der Wafer auf den für die Abscheidungsreaktion geeigneten Temperaturbereich erhitzt wurde, werden gasförmige Vorläufer zur Abscheidung in die Reaktionskammer eingeleitet. Die reaktiven Gase diffundieren zur Waferoberfläche und gehen dann bei hohen Temperaturen chemische Reaktionen auf der Waferoberfläche ein, um feste Ablagerungen (dünne Filme) zu bilden.
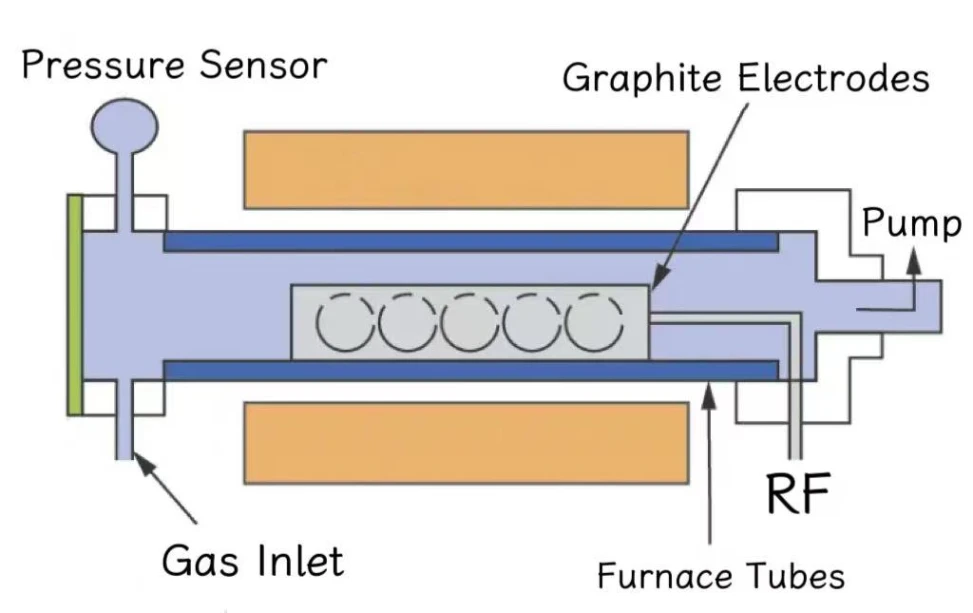
Vorteile von LPCVD-Verfahren
1. Hochwertige Dünnschichtabscheidungsqualität
Die Transportgeschwindigkeit der Reaktionsgase wird bei niedrigem Druck beschleunigt, da der Diffusionskoeffizient der Gase zunimmt. Dadurch kann eine gleichmäßigere Verteilung der Gasmoleküle in der gesamten Reaktionskammer geschaffen werden, was eine vollständige Reaktion der Gasmoleküle mit der Waferoberfläche gewährleistet und durch unvollständige Reaktionen verursachte Hohlräume oder Dickenunterschiede deutlich reduziert.
2. Hervorragende Stufenabdeckung dieses Films
Die verbesserte Gasdiffusionsfähigkeit unter niedrigem Druck ermöglicht es, tief in komplexe Strukturen einzudringen. Dadurch wird sichergestellt, dass das reaktive Gas in vollem Kontakt mit den Stufen und Gräben auf der Waferoberfläche ist, wodurch eine gleichmäßige Abscheidung dünner Filme erreicht wird. Daher ist die Dünnschichtabscheidung auf komplizierten Strukturen eine gute Anwendung für das LPCVD-Verfahren.
3. Starke betriebliche Kontrollierbarkeit
LPCVD-Prozesse weisen eine gute Kontrollierbarkeit während des tatsächlichen Betriebs auf. Die Zusammensetzung, Struktur und Dicke des dünnen Films können durch die Anpassung der Reaktantengasparameter wie Art, Durchflussrate, Temperatur und Druck präzise gesteuert werden. LPCVD-Geräte weisen im Vergleich zu anderen Abscheidungstechnologien relativ niedrige Investitions- und Betriebskosten auf und eignen sich daher für die großtechnische Industrieproduktion. Und die Konsistenz der Prozesse während der Massenproduktion kann effektiv durch automatisierte Systeme sichergestellt werden, die in Echtzeit überwachen und anpassen.
Nachteile von LPCVD-Verfahren
Da LPCVD-Prozesse typischerweise bei hohen Temperaturen durchgeführt werden, was die Anwendung einiger temperaturempfindlicher Materialien einschränkt, müssen Wafer, die durch LPCVD verarbeitet werden müssen, hitzebeständig sein. Bei LPCVD-Prozessen können unerwünschte Probleme auftreten, wie z. B. die Wafer-Wrap-Around-Abscheidung (dünne Filme, die in Nicht-Zielbereichen des Wafers abgeschieden werden) und Schwierigkeiten bei der In-situ-Dotierung, deren Lösung eine anschließende Verarbeitung erfordert. Darüber hinaus kann die geringe Konzentration von Dampfvorläufern unter Niederdruckbedingungen zu einer geringeren Dünnfilmabscheidungsrate führen, was zu einer ineffizienten Produktionseffizienz führt.
Semicorex bietet hohe QualitätSiC fUrnenrohrs, SiC freitragende PaddelUndSiC-Wafer-Bootefür LPCVD-Prozesse. Wenn Sie Fragen haben oder zusätzliche Informationen benötigen, zögern Sie bitte nicht, mit uns Kontakt aufzunehmen.
Kontaktieren Sie uns unter der Telefonnummer +86-13567891907
E-Mail: sales@semicorex.com





