
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Mainstream-Debonding-Methoden
Mit der Weiterentwicklung der Halbleiterverarbeitung und der steigenden Nachfrage nach elektronischen Bauteilen ist der Einsatz ultradünner Wafer (Dicke weniger als 100 Mikrometer) immer wichtiger geworden. Da die Waferdicke jedoch immer weiter abnimmt, sind Wafer bei nachfolgenden Prozessen wie Schleifen, Ätzen und Metallisieren sehr anfällig für Brüche.
Temporäre Bond- und Debonding-Technologien werden typischerweise eingesetzt, um die stabile Leistung und Produktionsausbeute von Halbleiterbauelementen zu gewährleisten. Der ultradünne Wafer wird vorübergehend auf einem starren Trägersubstrat fixiert und nach der Rückseitenbearbeitung werden beide getrennt. Dieser Trennvorgang wird als Debonding bezeichnet und umfasst vor allem thermisches Debonding, Laser-Debonding, chemisches Debonding und mechanisches Debonding.
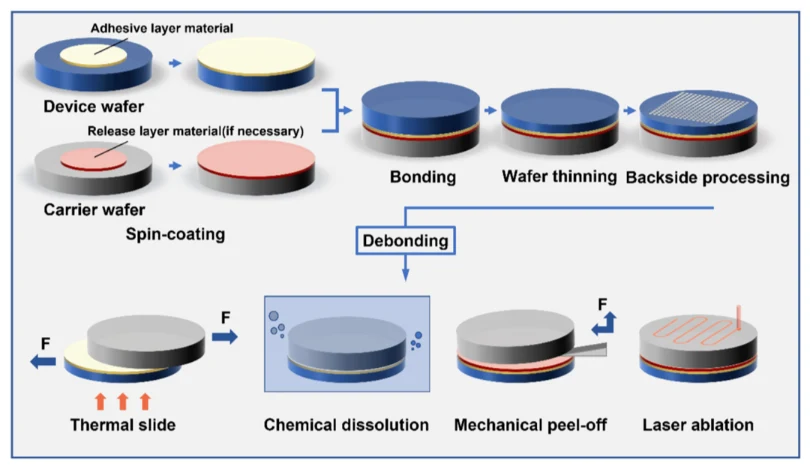
Thermisches Lösen
Beim thermischen Debonding handelt es sich um eine Methode, bei der ultradünne Wafer durch Erhitzen von Trägersubstraten getrennt werden, um den Bondkleber zu erweichen und zu zersetzen, wodurch seine Haftfähigkeit verloren geht. Es ist hauptsächlich in thermisches Gleit-Debonding und thermisches Zersetzungs-Debonding unterteilt.
Beim thermischen Slide-Debonding werden in der Regel verklebte Wafer auf ihre Erweichungstemperatur erhitzt, die etwa zwischen 190 °C und 220 °C liegt. Bei dieser Temperatur verliert der Bondkleber seine Haftfähigkeit und ultradünne Wafer können durch die Scherkraft von Geräten wie z. B. langsam von Trägersubstraten gedrückt oder abgezogen werdenVakuumspannfutterum eine reibungslose Trennung zu erreichen. Beim thermischen Zersetzungs-Debonding werden verklebte Wafer auf eine höhere Temperatur erhitzt, was zu einer chemischen Zersetzung (Molekülkettenspaltung) des Klebstoffs führt und dessen Haftung vollständig verliert. Dadurch können verklebte Wafer auf natürliche Weise ohne mechanische Krafteinwirkung gelöst werden.
Laser-Debonding
Beim Laser-Debonding handelt es sich um eine Debonding-Methode, bei der die Klebeschicht gebondeter Wafer mit Laser bestrahlt wird. Die Klebeschicht absorbiert die Laserenergie und erzeugt Wärme, wodurch eine photolytische Reaktion stattfindet. Dieser Ansatz ermöglicht die Trennung ultradünner Wafer von Trägersubstraten bei Raumtemperatur oder relativ niedrigen Temperaturen.
Eine entscheidende Voraussetzung für das Laser-Debonding ist jedoch, dass das Trägersubstrat für die verwendete Laserwellenlänge transparent sein muss. Auf diese Weise kann die Laserenergie erfolgreich das Trägersubstrat durchdringen und vom Verbindungsschichtmaterial effektiv absorbiert werden. Aus diesem Grund ist die Auswahl der Laserwellenlänge von entscheidender Bedeutung. Typische Wellenlängen sind 248 nm und 365 nm, die auf die optischen Absorptionseigenschaften des Verbindungsmaterials abgestimmt sein sollten.
Chemische Entbindung
Durch chemisches Debonding werden gebondete Wafer getrennt, indem die Klebeschicht mit einem speziellen chemischen Lösungsmittel aufgelöst wird. Dieser Prozess erfordert, dass Lösungsmittelmoleküle in die Klebeschicht eindringen, um ein Quellen, eine Kettenspaltung und schließlich eine Auflösung zu bewirken, was eine natürliche Trennung ultradünner Wafer und Trägersubstrate ermöglicht. Daher ist keine zusätzliche Heizausrüstung oder mechanische Kraft durch Vakuumspannfutter erforderlich, und die chemische Ablösung erzeugt nur eine minimale Belastung für die Wafer.
Bei dieser Methode werden Trägerwafer häufig vorgebohrt, damit das Lösungsmittel vollständig mit der Verbindungsschicht in Kontakt kommen und diese auflösen kann. Die Klebstoffdicke beeinflusst die Effizienz und Gleichmäßigkeit der Lösungsmitteldurchdringung und -auflösung. Lösliche Klebeklebstoffe sind meist thermoplastische oder modifizierte Polyimid-basierte Materialien, die üblicherweise durch Rotationsbeschichtung aufgetragen werden.
Mechanisches Lösen
Beim mechanischen Debonding werden ultradünne Wafer von den temporären Trägersubstraten ausschließlich durch Anwendung einer kontrollierten mechanischen Abziehkraft getrennt, ohne Hitze, chemische Lösungsmittel oder Laser. Der Vorgang ähnelt dem Abziehen von Klebeband, bei dem der Wafer durch einen präzisen mechanischen Vorgang sanft „angehoben“ wird.
Semicorex bietet hohe QualitätSIC-Spannfutter aus poröser Keramik. Wenn Sie Fragen haben oder zusätzliche Informationen benötigen, zögern Sie bitte nicht, mit uns Kontakt aufzunehmen.
Kontaktieren Sie uns unter der Telefonnummer +86-13567891907
E-Mail: sales@semicorex.com




